
 更新時間:2025-09-05
更新時間:2025-09-05  瀏覽次數(shù):97
瀏覽次數(shù):97SEM-sakamoto坂本電機數(shù)字水平儀SELN-001B憑借其±0.001°的高精度雙軸測量能力,成為半導體制造設備校準的關鍵工具。在光刻、刻蝕、鍍膜等核心工藝中,該儀器通過以下方式提升生產(chǎn)效率與產(chǎn)品良率:
一、核心功能與優(yōu)勢
1. 雙軸同步測量
同時檢測X/Y軸傾斜,避免單軸測量導致的調整誤差,確保設備水平度在0.001°級精度內(nèi)。
測量分辨率達0.0002°,零點重復性±0.001°或更低,滿足半導體設備對微小傾斜的嚴苛要求。
2. 實時數(shù)字反饋與遠程監(jiān)控
通過4.3英寸彩色LCD觸摸屏或外接顯示器直接顯示角度值,支持μm/m或角度單位(°、°′″)切換。
數(shù)據(jù)可實時輸出至云端或本地系統(tǒng),配合AI算法生成三維空間偏差分析報告,優(yōu)化調整流程。
3. 抗干擾設計與環(huán)境適應性
采用電磁屏蔽和振動補償算法,確保在半導體車間復雜電磁環(huán)境與機械振動下的測量穩(wěn)定性。
工作溫度范圍-10°C至+50°C,適應無塵車間恒溫控制需求。
二、在半導體制造中的具體應用案例
1、光刻機校準
晶圓臺調平:光刻機工作臺傾斜會導致焦平面偏移,影響曝光精度。SELN-001B可快速檢測并調整至≤0.001°,確保EUV/DUV光刻的成像質量。
光學系統(tǒng)校準:用于調整反射鏡、透鏡組的角度,優(yōu)化光路準直,減少像差,提升關鍵尺寸(CD)控制精度。
2、刻蝕設備調平
反應腔室調平:確保等離子體均勻分布,避免刻蝕速率不均(如邊緣與中心差異),提升晶圓內(nèi)均勻性(WIU)。晶圓承載臺校準:雙軸同步測量優(yōu)化承載臺水平度,減少刻蝕偏差,降低缺陷率。
3、鍍膜設備安裝
真空腔室調平:高精度調平縮短設備安裝時間,提高鍍膜均勻性,滿足納米級薄膜工藝要求。
蒸發(fā)源角度校準:確保材料沉積厚度一致,減少薄膜應力導致的晶圓彎曲。
4、后道工藝支持
CMP(化學機械拋光):拋光平臺水平度直接影響晶圓表面平坦度,SELN-001B可實時監(jiān)測并調整,降低表面粗糙度(Ra)。
晶圓鍵合機:在3D NAND等堆疊工藝中,確保鍵合界面對準精度,減少層間錯位。
三、技術升級與行業(yè)影響
1、智能化演進
通過藍牙5.2模塊與專屬APP聯(lián)動,實現(xiàn)測量數(shù)據(jù)實時同步與遠程操控,減少人工干預。
觸覺反饋系統(tǒng)在檢測面傾斜超過預定時間通過手柄振動警示,提升嘈雜環(huán)境下的操作效率。
2、模塊化設計
支持后期加裝GNSS定位模塊,為智慧工地建設提供硬件支持,助力半導體工廠數(shù)字化管理。
3、行業(yè)認可與案例
該型號已成功應用于東京灣跨海隧道、新加坡深層排水系統(tǒng)等重大工程,其高精度與可靠性在半導體行業(yè)得到廣泛驗證。
四、未來展望
隨著半導體制造向更小節(jié)點(如2nm及以下)邁進,設備水平度要求將更加嚴苛。SELN-001B的下一代產(chǎn)品計劃集成AR虛擬標線功能,進一步模糊傳統(tǒng)測量工具與數(shù)字孿生技術的邊界,為半導體行業(yè)提供更高效的解決方案。
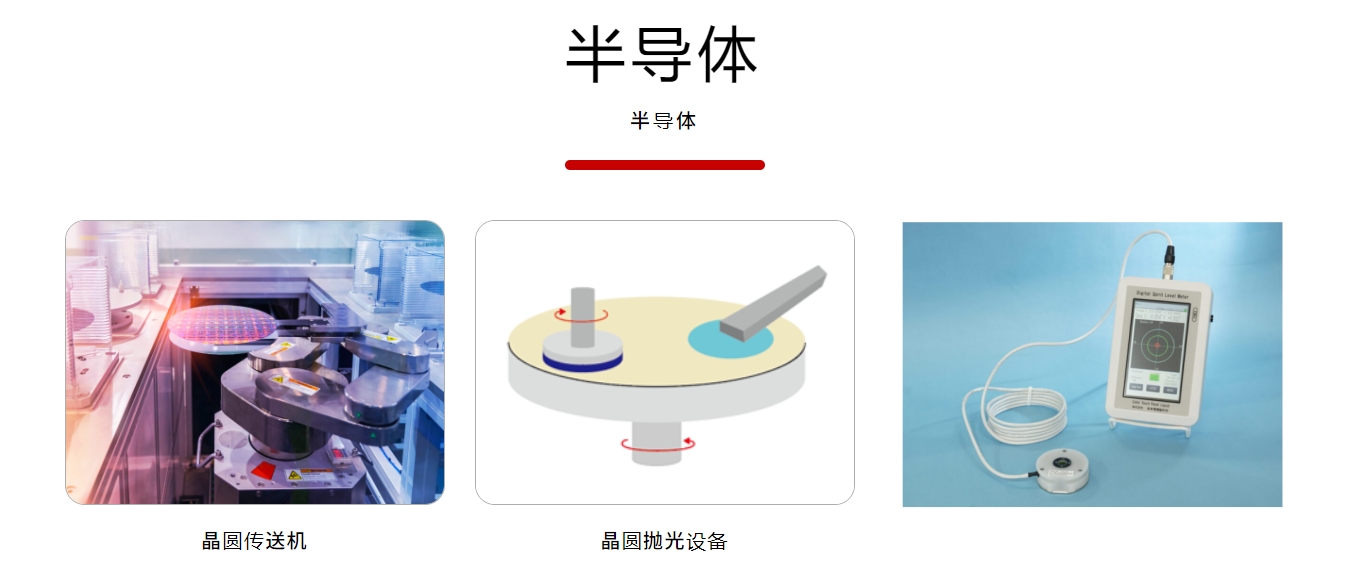
 產(chǎn)品分類
產(chǎn)品分類
products category
 掃一掃
掃一掃